引言
磁控濺射(MagnetronSputtering,MS)[1-10]鍍膜技術(shù)是當(dāng)今獲得各種功能薄膜的重要技術(shù)。磁控濺射鍍膜技術(shù)比蒸發(fā)鍍膜技術(shù)的膜-基結(jié)合力好,比陰極電弧離子鍍膜技術(shù)的膜層組織細(xì)密,較早應(yīng)用于大面積幕墻玻璃上鍍制節(jié)能膜、陽(yáng)光膜等。磁控濺射在鍍制半導(dǎo)體器件、顯示器件、太陽(yáng)能熱水器、太陽(yáng)能電池、手機(jī)、手表、五金箱包、幕墻玻璃、節(jié)能玻璃等功能薄膜方面發(fā)揮了不可替代的重要作用,在電梯裝飾板、工模具、汽車、船舶等的耐磨零件鍍膜方面發(fā)揮了重大作用。圖1所示的各種高新技術(shù)產(chǎn)品的制作過(guò)程中都采用了磁控濺射技術(shù)。

隨著能源、微電子、航空航天、光學(xué)及高端制造業(yè)等高新技術(shù)領(lǐng)域的發(fā)展,對(duì)高性能表面材料的需求快速增長(zhǎng),進(jìn)而推動(dòng)了磁控濺射鍍膜技術(shù)的進(jìn)步。本文介紹磁控濺射原理和技術(shù)特點(diǎn),綜述了磁控濺射靶結(jié)構(gòu)、鍍膜電源、工藝和應(yīng)用等方面的進(jìn)展,以及在工模具和耐磨零件鍍膜中的重要作用。
1、磁控濺射鍍膜技術(shù)原理及優(yōu)缺點(diǎn)
濺射鍍膜技術(shù)是利用輝光放電中的氬離子對(duì)靶材產(chǎn)生陰極濺射作用,將靶材原子濺射下來(lái)沉積到工件表面形成膜層的鍍膜技術(shù)[1-10]。圖2為陰極濺射原理圖[1-2]。靶材接磁控濺射電源負(fù)極,鍍膜室內(nèi)通入氬氣。接通磁控濺射電源以后產(chǎn)生輝光放電,氬離子在靶材所加負(fù)電壓的吸引下加速轟擊陰極靶材,高能氬原子將靶材原子濺射下來(lái)沉積到工件上形成膜層。
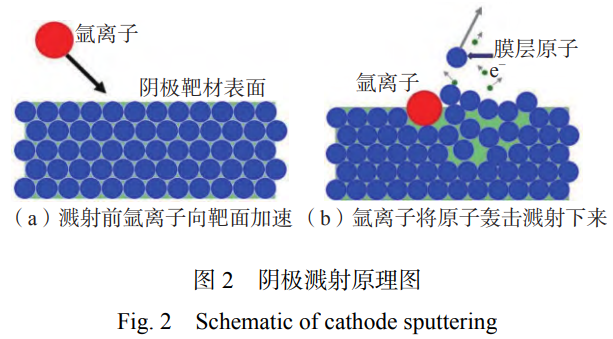
磁控濺射鍍膜技術(shù)是在陰極濺射靶后面增加磁場(chǎng),從而在靶的前面建立起正交電磁場(chǎng),約束電子在靶面前方空間不斷地做擺線(也稱旋輪線)運(yùn)動(dòng),提高電子和氬氣的碰撞幾率,使氬離子流增大,對(duì)靶表面的濺射速率增大,從靶上濺射的原子數(shù)量增多,沉積速率大幅提高。磁控濺射鍍膜技術(shù)比不加磁場(chǎng)的陰極濺射鍍膜的沉積速率高10倍以上[1-3],達(dá)到產(chǎn)業(yè)化應(yīng)用水平,成為當(dāng)今制備高新技術(shù)產(chǎn)品中各種功能薄膜的主要技術(shù)之一。
磁控濺射靶分為平面磁控濺射靶和柱狀磁控濺射靶。圖3為平面磁控濺射靶剖面結(jié)構(gòu)示意圖[1-10]。平面磁控濺射靶結(jié)構(gòu)簡(jiǎn)單,無(wú)運(yùn)動(dòng)部件,但是濺射刻蝕不均勻,靶材利用率低。
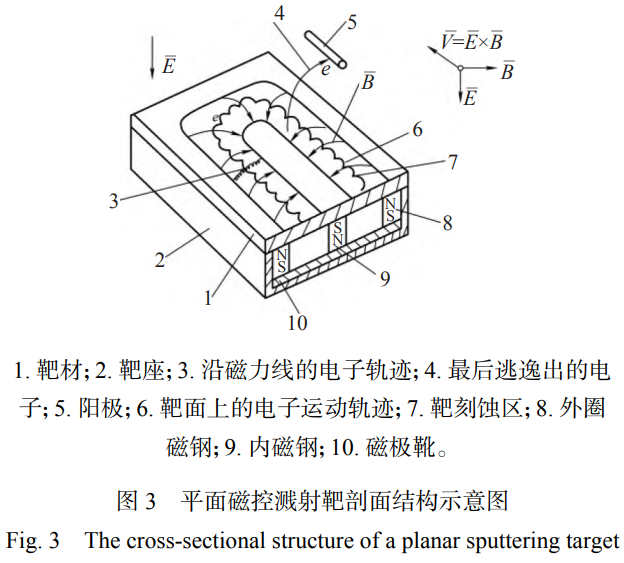
早期,平面磁控濺射靶的外圈磁鋼和內(nèi)磁鋼全部采用強(qiáng)磁鋼釹鐵硼,磁力線被緊緊地約束在靶面附近,遠(yuǎn)離靶面的區(qū)域沒(méi)有電子和氬氣碰撞,氬離子很少,幾乎沒(méi)有濺射作用。因此工件與靶的距離(靶-基距)只能在90mm以內(nèi)。這種磁場(chǎng)稱“平衡磁場(chǎng)”。
圖4為柱狀磁控濺射靶靶管內(nèi)磁鋼的排布圖[1-2,6-9]。圖4(a)為旋磁型柱狀磁控靶,工作時(shí)磁鋼旋轉(zhuǎn),靶管不動(dòng),靶管內(nèi)的磁鋼座連續(xù)旋轉(zhuǎn),帶動(dòng)靶面上的輝光圈旋轉(zhuǎn),可以實(shí)現(xiàn)向周圍360°方向鍍膜。圖4(b)為旋靶管型柱狀磁控濺射靶[1-2,6-9],工作時(shí)磁鋼不動(dòng),靶管旋轉(zhuǎn),并連續(xù)經(jīng)過(guò)輝光圈,靶面原子被連續(xù)濺射,不斷地向工件方向運(yùn)動(dòng),沉積成膜。柱狀磁控濺射靶比平面靶的靶材利用率高,不容易發(fā)生“靶中毒”現(xiàn)象,靶管材料成分可以多種多樣,可以在不銹鋼管表面噴涂各種被鍍材料,如Si、Cr等。當(dāng)靶管內(nèi)的N-S-N磁極全部采用釹鐵硼強(qiáng)磁鋼時(shí),屬于平衡磁場(chǎng)的排布方式。
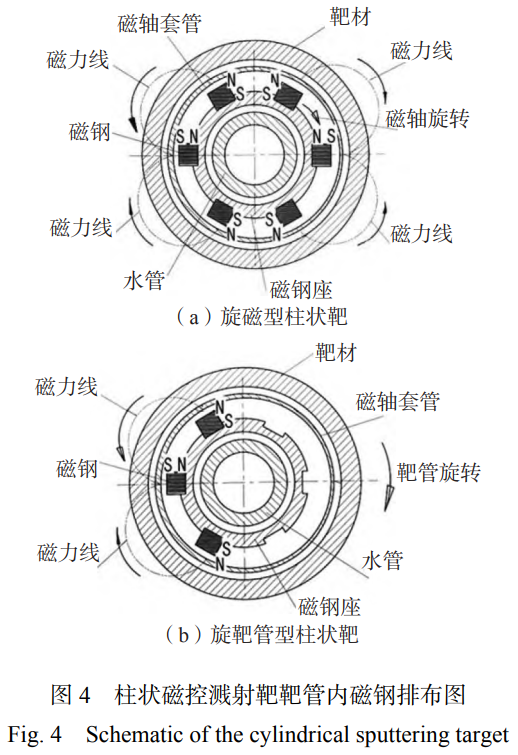
傳統(tǒng)磁控濺射鍍膜技術(shù)具有一定的優(yōu)越性,例如:膜層組織比電弧離子鍍細(xì)密;沉積粒子的能量比蒸發(fā)鍍膜的高,膜基附著力比蒸發(fā)鍍好;膜層成分與靶材成分接近,薄膜均勻性好等,適合于各類功能膜的鍍制。但是,在鍍制耐磨與裝飾膜等方面,磁控濺射比陰極電弧離子鍍的離化率低,因此,膜基結(jié)合力相對(duì)較低,沉積速率低,難于形成化合物膜層,沉積絕緣膜時(shí)容易“靶中毒”[1-3],影響了其技術(shù)優(yōu)勢(shì)的發(fā)揮。
2、磁控濺射鍍膜技術(shù)新進(jìn)展
近幾十年來(lái),研究人員在提高磁控濺射鍍膜技術(shù)的金屬離化率、膜基結(jié)合力、靶材利用率、沉積速率以及克服靶中毒等方面作了很多努力,取得了顯著成果。
2.1 非平衡磁控濺射技術(shù)
傳統(tǒng)磁控濺射靶采用平衡磁場(chǎng)設(shè)計(jì),靶-基距小,工件裝載量小,生產(chǎn)效率低,離化率低。近些年在平衡磁場(chǎng)的基礎(chǔ)上發(fā)明了采用非平衡磁控濺射靶和非平衡閉合磁場(chǎng)的磁控濺射鍍膜技術(shù)。
(1)非平衡磁控濺射靶磁場(chǎng)的排布
非平衡磁控濺射靶的磁場(chǎng)排布使靶心部磁鋼與周邊磁體的磁場(chǎng)強(qiáng)度不相等[1-3,9,11-15]。可以是心部采用強(qiáng)磁鋼,周邊使用弱磁性材料,或者是心部采用弱磁材料,周邊采用強(qiáng)磁鋼。圖5(a)和圖5(b)分別為平衡和非平衡磁控濺射靶靶面磁力線分布[1-3,9,11-15]。
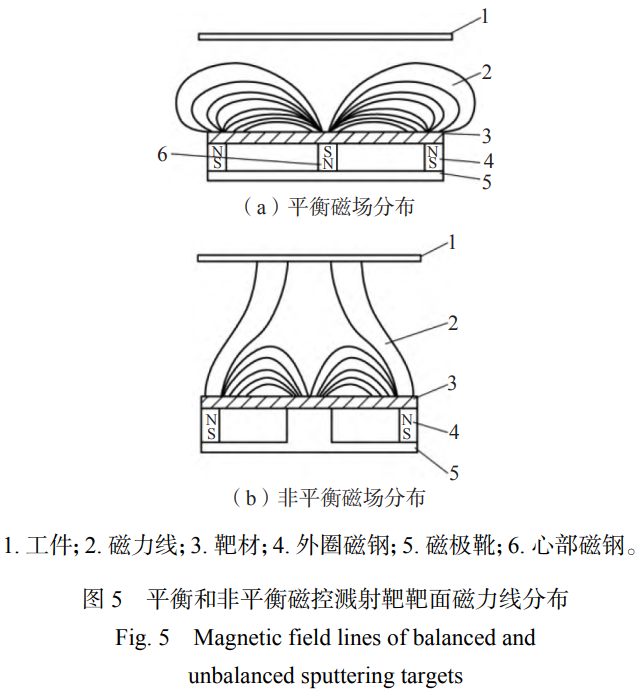
圖6為英國(guó)Gencoa公司的平衡和非平衡磁控濺射靶靶面磁力線分布的計(jì)算機(jī)仿真模擬圖[1-2,13]。由圖可以看出,非平衡磁控濺射靶靶面上磁力線向靶的前方推移,向靶兩邊擴(kuò)展,并推向離靶面更遠(yuǎn)的地方,使靶-基距提高到150mm,即磁場(chǎng)的作用空間擴(kuò)展了。

(2)非平衡閉合磁場(chǎng)
如果將相鄰的兩個(gè)非平衡磁控濺射靶的磁極性反向排列,一個(gè)靶的磁極性是N-S-N,另一個(gè)靶的磁極性是S-N-S,兩靶周邊的磁極性分別為N-S、S-N,相互吸引,磁力線交聯(lián),在整個(gè)鍍膜室內(nèi)形成閉合磁場(chǎng)。鍍膜室內(nèi)的電子受到電磁場(chǎng)的約束,不能逃逸到鍍膜室壁上,而是在鍍膜室內(nèi)做旋轉(zhuǎn)運(yùn)動(dòng),與更多的氬氣和成膜原子碰撞,使它們電離,因此,等離子體密度提高。這種方法只需改變磁場(chǎng)的排布就可以將電子束縛在鍍膜室內(nèi),增加碰撞幾率,增強(qiáng)磁控濺射的等離子體密度。
圖7為Teer公司的平面非平衡閉合磁場(chǎng)磁控濺射鍍膜機(jī)原理圖和計(jì)算機(jī)仿真模擬圖[1-2,14-15]。在圖7(a)中,上下靶的內(nèi)磁鋼排列為靶的中間是S,周邊是N,左右靶的內(nèi)磁鋼的排列為靶中間是N,周邊是S,即相鄰兩個(gè)靶周邊的磁極性一個(gè)是N,另一個(gè)是S,兩個(gè)靶之間磁力線交聯(lián)。電子在兩個(gè)靶之間做旋轉(zhuǎn)運(yùn)動(dòng),與更多的氬原子碰撞使其電離。
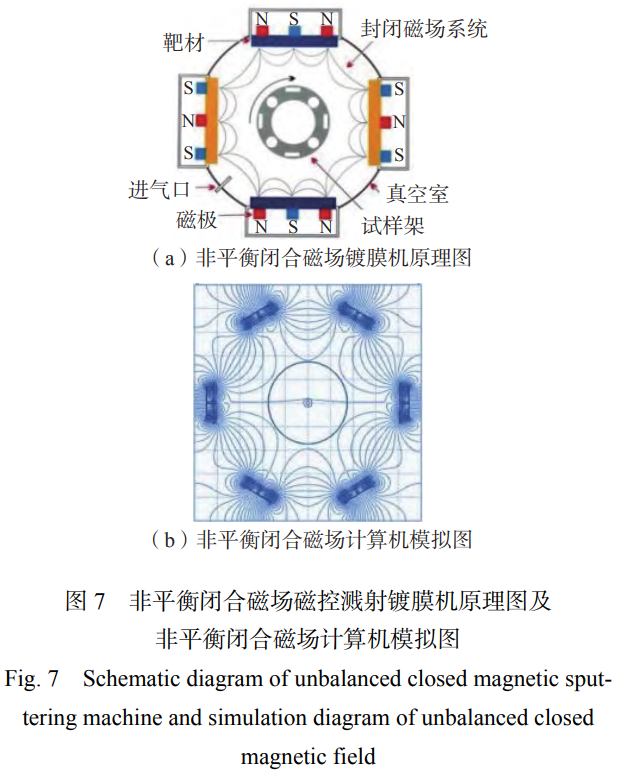
從圖7(b)可以看出,鍍膜室內(nèi)安裝6個(gè)非平衡磁控濺射靶,靶前面有磁力線,相鄰兩個(gè)靶之間也有磁力線交聯(lián),整個(gè)鍍膜室內(nèi)的磁場(chǎng)全封閉。
圖8為Teer公司的計(jì)算機(jī)三維仿真模擬圖[15]。

圖9是Hauzer公司非平衡閉合磁場(chǎng)磁控濺射鍍膜機(jī)結(jié)構(gòu)示意圖[1-3,9,16]。鍍膜室內(nèi)的四個(gè)平面非平衡磁控濺射靶除了后面安裝了永磁體外,每個(gè)平面靶的周圍還加裝了電磁線圈。電磁場(chǎng)的方向與靶內(nèi)側(cè)邊永磁體外圈的磁極性相同,增強(qiáng)了平面靶周邊的磁場(chǎng)強(qiáng)度,同時(shí)增強(qiáng)了相鄰兩個(gè)靶之間磁場(chǎng)強(qiáng)度。

圖10[9]為一個(gè)后面有永磁體的磁控靶增加了電磁線圈后靶周邊的磁力線示意圖。當(dāng)增強(qiáng)兩個(gè)磁控濺射靶側(cè)邊的磁場(chǎng)強(qiáng)度時(shí),即可增強(qiáng)磁場(chǎng)的閉合效果,改善鍍膜室內(nèi)等離子體密度和作用范圍。

非平衡閉合磁場(chǎng)不僅能夠提高磁控濺射鍍膜時(shí)成膜原子的離化率,提高沉積速率,還能夠提高沉積粒子的活性,使之能夠在較低溫度下反應(yīng)生成化合物薄膜,如CrN、WC等,也可以采用石墨濺射靶直接沉積類金剛石薄膜(DLC),類石墨膜(GLC)等碳基薄膜。沉積硬質(zhì)薄膜的溫度可以降低至200℃以下。圖11中左邊為Hauzer公司的非平衡閉合磁場(chǎng)磁控濺射鍍膜機(jī),右邊顏色較深的是利用該設(shè)備先用磁控濺射鍍CrN、WC硬質(zhì)膜,再在同一鍍膜機(jī)中用PECVD技術(shù)鍍DLC膜的產(chǎn)品[1-2]。

圖12是采用非平衡磁控濺射技術(shù)為汽車發(fā)動(dòng)機(jī)、飛機(jī)、機(jī)床、船舶鍍制了硬質(zhì)薄膜的精密耐磨零件[1-20]。這些零件原本大多采用淬火后低溫回火工藝,采用以上新技術(shù)將硬質(zhì)薄膜的應(yīng)用領(lǐng)域擴(kuò)寬到200℃以下回火的耐磨零件,為高端制造業(yè)帶來(lái)了突破性進(jìn)展。

圖13是采用非平衡磁控濺射技術(shù)沉積了金屬化合物硬質(zhì)涂層和DLC減摩涂層的各種模具。鍍膜后,模具硬度提高,易脫模,表面的光亮度顯著提高。
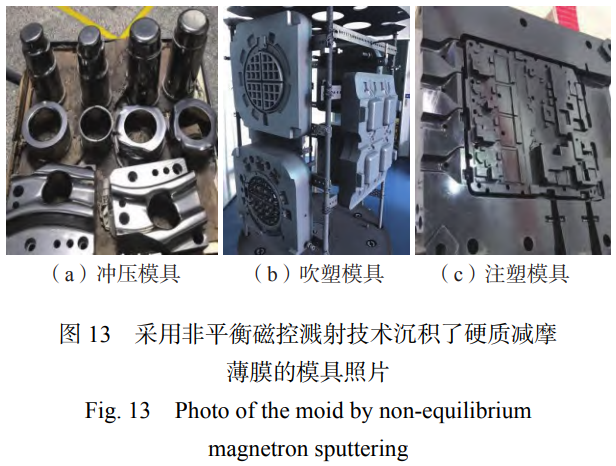
碳基薄膜的優(yōu)點(diǎn)是既有1200~6500HV的硬度,又具有很低的摩擦系數(shù)。拋光鋼板的摩擦系數(shù)是0.8。CrN、TiN的摩擦系數(shù)是0.4。DLC、GLC的摩擦系數(shù)是0.1、0.05。在金屬氮化物硬質(zhì)涂層的表面再鍍制一層碳膜,相當(dāng)于在硬質(zhì)薄膜表面又穿上一層自潤(rùn)滑新外衣[1-2,19-20]。而一般耐磨零件經(jīng)過(guò)淬火加200℃回火的硬度只有60HRC(相當(dāng)于700HV)。該技術(shù)使傳統(tǒng)熱處理工模具和耐磨零件的壽命大幅度提高。近些年,這一技術(shù)在我國(guó)取得了飛速發(fā)展,大幅提高了高端制造業(yè)產(chǎn)品的國(guó)際競(jìng)爭(zhēng)力。
(3)柱狀非平衡磁控濺射靶
旋靶管型柱狀磁控濺射靶也可以排布出非平衡磁場(chǎng)。圖14為柱狀靶內(nèi)磁鋼的三種排布方式[1-2]。其中,圖14(a)為N-S-N磁極全部采用強(qiáng)磁鋼釹鐵硼的平衡磁場(chǎng)排布示意圖。圖14(b)為兩邊強(qiáng)磁鋼(黑)中間弱磁體(紅)的非平衡磁場(chǎng)排布示意圖。圖14(c)為中間強(qiáng)磁鋼兩邊弱磁體的非平衡磁場(chǎng)排布示意圖。
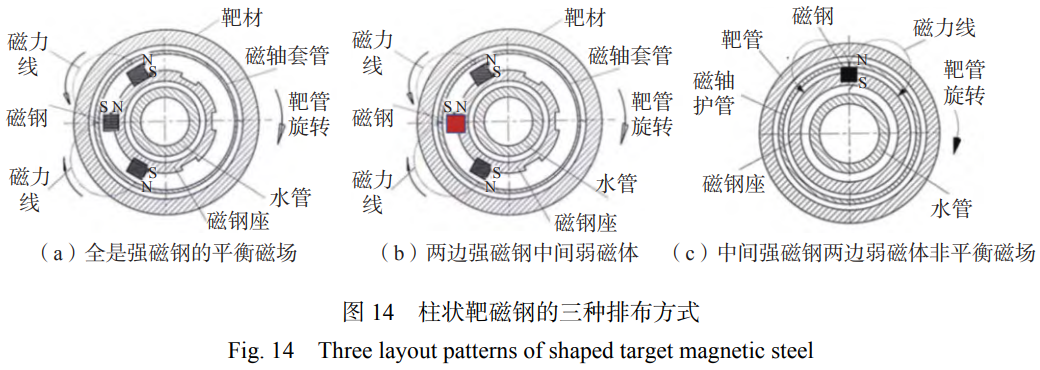
圖14(c)是作者首次提出的只安裝一條強(qiáng)磁鋼的旋靶管型柱狀非平衡磁控濺射靶[21-22]的磁鋼排布圖,即在磁鋼座上排布一條釹鐵硼強(qiáng)磁鋼,N極朝向靶前方,S極將磁鋼座磁化,整個(gè)磁鋼座成為S極,靶面前形成從N到S的磁場(chǎng)分布。圖15為圖14(c)的原理圖,磁鋼座是導(dǎo)磁材料,被強(qiáng)磁鋼的S極磁化,但是磁極性低于強(qiáng)磁鋼,形成非平衡磁場(chǎng)。靶面前磁力線同時(shí)向前方更遠(yuǎn)處和周邊擴(kuò)展。

表1[23]為在同一臺(tái)鍍膜機(jī)上分別采用安裝一條強(qiáng)磁鋼的非平衡磁場(chǎng)和三條強(qiáng)磁鋼的平衡磁場(chǎng)條件鍍制CrC薄膜的性能對(duì)比數(shù)據(jù)。實(shí)驗(yàn)采用恒功率模式和恒流模式鍍膜工藝,均先鍍3minCr底層,再鍍27minCrC膜。由表中數(shù)據(jù)可知,分別采用這兩種磁場(chǎng)時(shí),所鍍CrC薄膜的質(zhì)量基本相同。對(duì)比兩種工藝的表面磁感應(yīng)強(qiáng)度測(cè)試結(jié)果發(fā)現(xiàn),安裝一條強(qiáng)磁鋼的為27~29mT,安裝三條的為33~35mT,都可以滿足磁控濺射靶靶面所需磁場(chǎng)強(qiáng)度的要求。
表 1 在安裝不同數(shù)量磁鋼的磁場(chǎng)中鍍膜的質(zhì)量對(duì)比表(Tab. 1 Comparison of coating quality in magnetic fields of different quantities of magnetic steel)
| 模式 | 磁鋼數(shù)量 / 條 | 膜層厚度 /μm | 色度 L | 色度 a | 色度 b | 納米硬度 /GPa |
| 恒功率模式 | 1 | 1.110 | 70.03 | 0.42 | 4.67 | 10.40 |
| 恒功率模式 | 3 | 0.898 | 70~85 | 0.38 | 4.56 | 9.03 |
| 恒流模式 | 1 | 0.705 | 60.62 | 0.40 | 4.24 | 7.08 |
| 恒流模式 | 3 | 0.603 | 55.51 | 0.42 | 4.28 | 6.84 |
作者還對(duì)安裝一條強(qiáng)磁鋼和三條強(qiáng)磁鋼的柱狀磁控濺射靶分別在氬氣條件下和氮?dú)鈼l件下進(jìn)行了放電實(shí)驗(yàn)。圖16為放電形貌照片,圖中藍(lán)色部分為在氬氣中的放電,櫻紅色部分為通入氮?dú)夂蟪练eTiN的照片。從圖16可知,兩種排布方式的放電特性基本相同,說(shuō)明采用一條磁場(chǎng)的柱狀磁控濺射靶的靶面磁場(chǎng)強(qiáng)度和采用三條強(qiáng)磁鋼都能滿足磁控濺射靶的放電要求。

作者針對(duì)直徑1m的鍍膜室內(nèi)安裝八個(gè)非平衡柱狀磁控濺射靶(每個(gè)靶管內(nèi)僅安裝一條強(qiáng)磁鋼,且相鄰柱狀靶的磁極性呈相反排布)的情形開(kāi)展了計(jì)算機(jī)仿真模擬[1-2],如圖17所示。由圖17可知,安裝八個(gè)柱狀磁控濺射靶,每個(gè)靶只有一條強(qiáng)磁鋼,八個(gè)靶的磁極性反向排列,整個(gè)鍍膜室內(nèi)形成了全封閉非平衡閉合磁場(chǎng),與平面非平衡閉合磁場(chǎng)的排布結(jié)果相似,可以束縛電子在鍍膜室內(nèi)做連續(xù)旋轉(zhuǎn)運(yùn)動(dòng),提高碰撞幾率,提高沉積速率和金屬離化率。

圖18為作者完成的柱狀磁控濺射靶三種磁鋼排布方式下鍍膜室內(nèi)磁通密度分布的計(jì)算機(jī)仿真圖。圖中磁通密度值越高,顏色越紅。

由圖18可知,安裝三條強(qiáng)磁鋼的平衡磁控濺射靶的磁通密度被緊緊地約束在靶的附近,鍍膜室內(nèi)部的磁通密度很低。其他兩種非平衡排布的磁通密度都向鍍膜室中心擴(kuò)展。其中安裝一條強(qiáng)磁鋼的擴(kuò)展效果最好,可以約束整個(gè)鍍膜室內(nèi)更多的電子做旋轉(zhuǎn)運(yùn)動(dòng)并與氬原子和成膜原子產(chǎn)生更激烈的非彈性碰撞,提高沉積速率和膜層粒子的活性,更容易沉積獲得硬質(zhì)薄膜。總之,柱狀靶的結(jié)構(gòu)簡(jiǎn)單、尺寸小,鍍膜室內(nèi)可以安裝多個(gè)靶,相鄰兩個(gè)柱狀靶分別安裝不同成分的靶材,可以獲得更細(xì)密的納米多層膜,進(jìn)一步提高膜層的硬度和耐腐蝕性,擴(kuò)展磁控濺射鍍膜技術(shù)的應(yīng)用范圍。
綜上所述,采用非平衡閉合磁場(chǎng)排列的磁控濺射靶提高了鍍膜室內(nèi)電子的利用率,提高了鍍膜室內(nèi)的等離子體密度,相比平衡磁場(chǎng)排布可以提高沉積速率并提高磁控濺射膜層粒子的離化率。
為了進(jìn)一步提高磁控濺射鍍膜的等離子體密度,作者還提出了采用弧光放電的高密度電子流增強(qiáng)輝光放電的磁控濺射鍍膜過(guò)程。圖19[24]為在非平衡閉合磁場(chǎng)的磁控濺射鍍膜室頂部安裝空心陰極槍的結(jié)構(gòu)示意圖。

鍍膜過(guò)程如下:首先利用空心陰極槍發(fā)射的高密度電子流使氬氣電離,產(chǎn)生高密度低能量的氬離子以清洗工件表面。隨后,空心陰極槍持續(xù)工作,同時(shí)開(kāi)啟磁控濺射靶進(jìn)行鍍膜。在此階段,空心陰極槍發(fā)射的高密度電子流可將氬氣和膜層原子電離,進(jìn)而彌補(bǔ)磁控濺射技術(shù)在沉積速率低、離化率低及化合物薄膜沉積工藝難度大等方面的不足。通過(guò)空心陰極產(chǎn)生的高密度電子流輔助沉積,可顯著提升磁控濺射鍍膜的工藝性能。
2.2 磁控濺射鍍介質(zhì)膜的技術(shù)進(jìn)步
高新技術(shù)產(chǎn)品中的半導(dǎo)體器件、光學(xué)器件、光電子器件、節(jié)能玻璃等都需要鍍Al2O3、SiO2、Si3N4、Nb2O5等介質(zhì)膜(絕緣膜)。例如,在寬度為3300mm、長(zhǎng)度為6800mm的Low-e節(jié)能玻璃上鍍多層節(jié)能膜的鍍制順序?yàn)椋合仍诓AЩ纳襄僑i3N4介質(zhì)膜,然后分別用Ag靶和CrNi合金靶直流磁控濺射鍍Ag、CrNi膜,再鍍Si3N4膜,如圖20[1-2,6,25]所示。
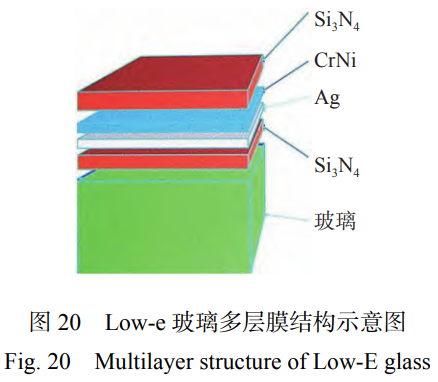
采用直流磁控濺射鍍Si3N4介質(zhì)膜時(shí),陰極靶面上會(huì)沉積絕緣膜,氬離子進(jìn)入不了靶陰極而是累積在其附近,氬離子堆積層和陰極靶材之間形成電位很高的鞘層,產(chǎn)生冷場(chǎng)致發(fā)射,因而出現(xiàn)打弧現(xiàn)象,即所謂“靶中毒”。陽(yáng)極上同樣會(huì)沉積絕緣膜,電子進(jìn)不了陽(yáng)極,即產(chǎn)生“陽(yáng)極消失”現(xiàn)象,使得鍍膜過(guò)程很難穩(wěn)定。經(jīng)過(guò)近幾十年的努力,研究人員研發(fā)出許多新技術(shù),如中頻電源匹配孿生靶磁控濺射技術(shù)等,提高了在高端器件和大尺寸玻璃上鍍介質(zhì)膜的質(zhì)量,促進(jìn)了產(chǎn)業(yè)化生產(chǎn)。
(1)采用中頻電源匹配孿生靶克服靶中毒和陽(yáng)極消失現(xiàn)象
雖然采用射頻濺射也可以鍍制絕緣膜,但受限于沒(méi)有大功率射頻電源,目前只能采用頻率為20kHz、40kHz、100kHz的中頻電源。連接中頻電源的兩個(gè)磁控濺射靶稱為“孿生靶”。將中頻電源的兩個(gè)電極分別與兩個(gè)“孿生靶”連接,可以穩(wěn)定地鍍制介質(zhì)膜[1-3,6,25-27]。放電過(guò)程中,兩個(gè)靶互為陰陽(yáng)極,靶的電極性迅速變化。圖21(a)為孿生靶放電示意圖,當(dāng)陰極靶的電極性瞬時(shí)為正半周時(shí),吸引電子到達(dá)陰極,中和堆積的氬離子,消除“靶中毒”現(xiàn)象,不再發(fā)生打弧;當(dāng)陰極靶的電極性瞬時(shí)為負(fù)半周時(shí),吸引氬離子到達(dá)陽(yáng)極,中和堆積的電子,消除“陽(yáng)極消失現(xiàn)象”,使鍍膜過(guò)程穩(wěn)定進(jìn)行。圖21(b)為孿生靶電位變化圖[8]。
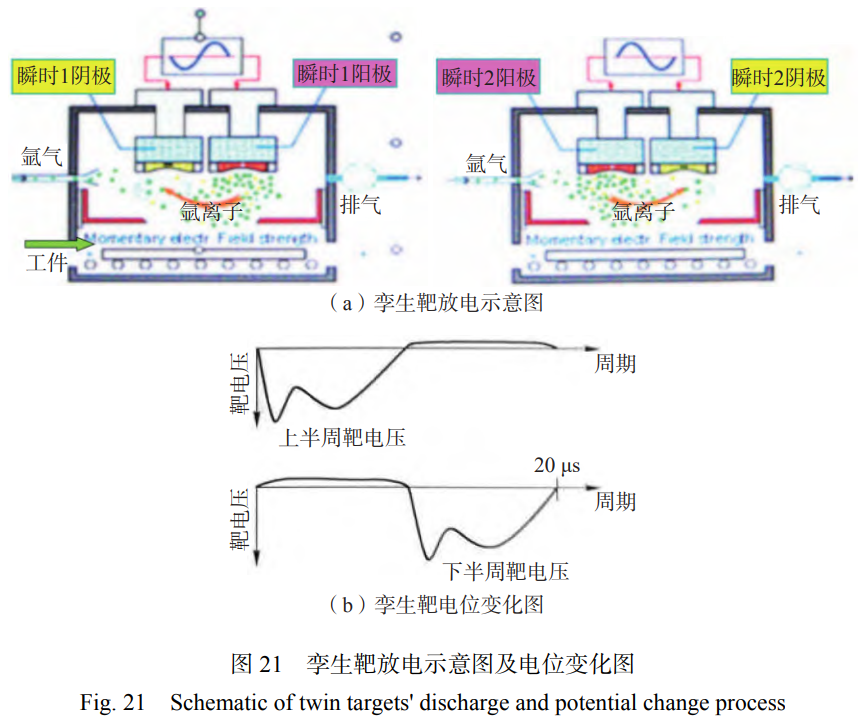
孿生靶通常采用純組分材料制成,兩個(gè)靶可以并排安放,也可以對(duì)向安裝。通入反應(yīng)氣體放電后電子、離子在兩個(gè)靶之間來(lái)回振蕩。
圖22為在同一個(gè)設(shè)備中分別用中頻磁控濺射和直流磁控濺射沉積鎳膜時(shí)靶的放電照片[1-3]。可以看出,采用中頻電源時(shí)靶面輝光比直流放電強(qiáng),說(shuō)明靶前面的等離子體密度提高。

圖23為AppliedFilms公司在寬度為3300mm、長(zhǎng)度為6800mm的玻璃上鍍Low-e多層膜時(shí)采用的孿生Si靶,該靶是在直徑為150mm的不銹鋼管上噴涂Si形成的。

(2)控制反應(yīng)磁控濺射鍍膜的模式
通常采用中頻電源和純組分材料靶,通入氧氣、氮?dú)獾确磻?yīng)氣體鍍制Al2O3、SiO2、Si3N4等絕緣膜。通入反應(yīng)氣體的初期靶電壓高,沉積速率快,這一階段稱之為“金屬模式”。靶面沉積介質(zhì)膜后,電壓迅速降低,放電由金屬模式轉(zhuǎn)換為“反應(yīng)模式”,磁控濺射過(guò)程很難進(jìn)行。因此,沉積過(guò)程中須嚴(yán)格控制反應(yīng)氣體的通入量,使放電處于金屬模式以維持穩(wěn)定鍍膜過(guò)程。
控制反應(yīng)氣體通入量的方法有兩種[1-4,6-9,28]。一種是監(jiān)測(cè)靶電壓,當(dāng)靶電壓突然降低時(shí)反饋給進(jìn)氣系統(tǒng),減少反應(yīng)氣體的通入量。另一種是在沉積過(guò)程中檢測(cè)放電顏色(放電頻率)的變化,將等離子體信號(hào)迅速反饋給氣體控制系統(tǒng),調(diào)整反應(yīng)氣體進(jìn)氣流量來(lái)保證介質(zhì)膜的穩(wěn)定鍍制。
(3)采用分步沉積法
分步沉積(分區(qū)氧化法)[1-2,29]是先用純金屬靶材鍍一層純金屬膜,再將反應(yīng)氣體通入離子源進(jìn)行化合反應(yīng)以獲得氧化物等介質(zhì)膜。鍍膜過(guò)程不發(fā)生靶中毒,同時(shí)用純金屬靶材克服了反應(yīng)沉積過(guò)程中沉積速率慢的缺點(diǎn)。圖24為日本新科隆(Shicron)公司[1-2,29]的分區(qū)氧化法設(shè)備示意圖。這種方法的優(yōu)點(diǎn)是可以在更低溫度下沉積完全化學(xué)計(jì)量比或結(jié)構(gòu)更完整的化合物薄膜。

2.3 熱陰極增強(qiáng)磁控濺射技術(shù)
在各種提高磁控濺射鍍膜沉積速率的方法中,增加熱陰極來(lái)發(fā)射高密度電子流,提高電子與原子的碰撞幾率,增強(qiáng)對(duì)靶的濺射的方法具有明顯的優(yōu)勢(shì)。
美國(guó)西南研究院在磁控濺射鍍膜機(jī)中增設(shè)了發(fā)射熱電子流的鎢絲,如圖25所示[30]。圖中兩邊安裝磁控濺射靶,中間安裝工件,工件下方發(fā)射熱電子的燈絲達(dá)到白亮狀態(tài)。

在磁控濺射鍍膜室內(nèi)增設(shè)鎢絲,將鎢絲加熱到2700℃的高溫以發(fā)射出高密度電子流,但是電子的熱能只相當(dāng)于0.27eV,不能與氬原子和成膜粒子產(chǎn)生碰撞電離。必須增設(shè)加速電極,在加速電極上施加70V以上的正電壓,將接負(fù)電極的鎢絲發(fā)射的熱電子加速成為高能量電子流[1-2,30-32]。高密度、高能量的電子流將更多的氬原子和成膜原子電離,從而提高濺射速率、沉積速率和金屬離化率,反應(yīng)沉積得到化合物薄膜。
圖26為增加熱陰極前后,用磁控濺射鍍TiSiCN硬質(zhì)薄膜的膜層形貌SEM照片。從圖26可以看出,無(wú)熱陰極時(shí),工件電流密度為0.2mA/cm2,增加熱陰極以后工件電流密度提高到4.9mA/cm2[1-2,28],且膜層組織更細(xì)密。可見(jiàn),在磁控濺射鍍膜技術(shù)中增設(shè)熱陰極對(duì)提高濺射速率和沉積速率,提高膜層粒子活性,進(jìn)行反應(yīng)沉積是非常有效的。美國(guó)西南研究院采用此技術(shù)顯著提高了汽輪機(jī)葉片、泥漿泵柱塞、研磨機(jī)零件的壽命[33]。圖27為采用熱陰極增強(qiáng)磁控濺射技術(shù)沉積了硬質(zhì)薄膜的耐磨零件照片。
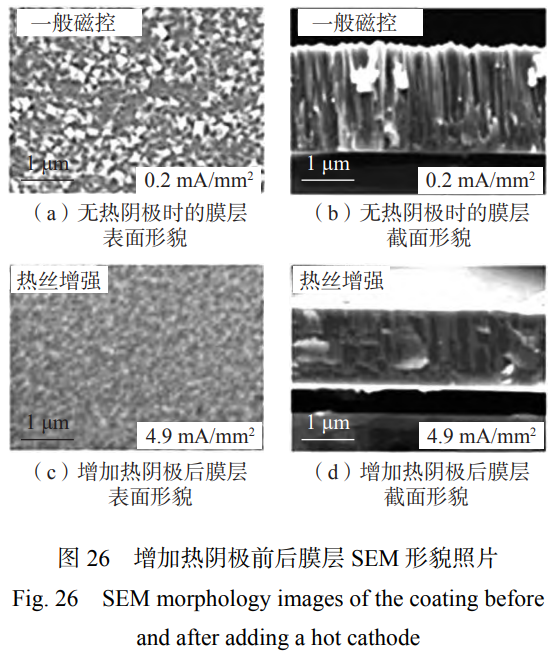

2.4 高功率脈沖磁控濺射技術(shù)
1999年,瑞典人Kouznetsov提出高功率脈沖磁控濺射技術(shù)(HighPowerImpulseMagnetronSputteringTechnology,HiPIMS)。該技術(shù)將高功率電源和非平衡磁控濺射靶相結(jié)合,提高了金屬離化率。近年來(lái),HiPIMS技術(shù)發(fā)展很快[1-2,34]。
(1)高功率脈沖磁控濺射鍍膜裝置
圖28為HiPIMS鍍膜裝置示意圖[1-2,34-37]。非平衡磁控濺射靶接高功率脈沖磁控濺射電源。接通電源后,工件(基片)和非平衡磁控濺射靶之間產(chǎn)生高密度的等離子體。

(2)高功率脈沖磁控濺射鍍膜主要參數(shù)
HiPIMS電源峰值功率很高,可達(dá)到1000~3000W/cm2,是普通磁控濺射的100倍。放電等離子體密度達(dá)1018m?3數(shù)量級(jí)。靶材離化率極高,濺射Cu靶的離化率可達(dá)70%,與陰極電弧離子鍍的離化率相當(dāng)。在相同條件下,等離子體中的離子種類發(fā)生了變化。圖29[1-2,34]為鍍TiN薄膜時(shí)的放電照片(電壓800V、脈寬250μs、頻率100Hz、氣壓0.5Pa)。圖29(a)為傳統(tǒng)直流磁控濺射放電的紫色光,由光譜分析可知主要為氮?dú)夥烹婋婋x;圖29(b)為HiPIMS放電時(shí)產(chǎn)生的藍(lán)色光,光譜分析主要為靶材金屬Ti放電電離,這表明金屬離化率較高,等離子體中大部分為Ti離子。較高份額的高能離子在沉積薄膜時(shí)有很多優(yōu)點(diǎn):可以提高薄膜質(zhì)量,比如密度和結(jié)合力;工件加偏壓后繞射性好,可對(duì)復(fù)雜形狀工件進(jìn)行沉積。

(3)高功率脈沖磁控濺射提高鍍膜質(zhì)量
HiPIMS可以獲得高份額的高能金屬離子,因此,所沉積的薄膜組織非常細(xì)密,性能優(yōu)異。圖30[1-2,35-36]為用HiPIMS技術(shù)沉積的CrN膜層的掃描電鏡組織形貌圖和原子力顯微鏡組織形貌圖[34]。圖31[1-2,37]為分別用直流磁控濺射和HiPIMS沉積的ZrN的掃描電鏡表面組織圖的對(duì)比。從圖31可以看出,用HiPIMS技術(shù)沉積的膜層組織比用常規(guī)磁控濺射沉積得更細(xì)密。

由于HiPIMS技術(shù)具有等離子體密度高、膜層離子的活性高、膜層離子的能量高等很多優(yōu)點(diǎn),近些年來(lái)發(fā)展很快,在微鉆、螺桿上沉積硬質(zhì)薄膜,在管狀零件的內(nèi)部沉積DLC潤(rùn)滑膜,在柔性材料表面沉積疏水膜等方面得到了廣泛應(yīng)用。我國(guó)生產(chǎn)的HiPIMS電源已經(jīng)達(dá)到很高水平[38],具備滅弧速度快、多重控制模式、多波形輸出能力,可通過(guò)手機(jī)終端遠(yuǎn)程調(diào)節(jié)至恒流/恒壓、恒功率模式,并實(shí)時(shí)監(jiān)測(cè)輸出電壓、電流等工藝參數(shù)。
3、總結(jié)
磁控濺射鍍膜技術(shù)在國(guó)家高新技術(shù)與高端制造業(yè)發(fā)展中發(fā)揮了關(guān)鍵作用。磁控濺射新技術(shù)的突破為高品質(zhì)薄膜制備提供了新途徑。其中,非平衡磁控濺射技術(shù)和高功率脈沖磁控濺射技術(shù)(HiPIMS)為提升耐磨零件與裝飾鍍膜質(zhì)量開(kāi)辟了有效路徑;中頻電源匹配孿生靶技術(shù)與反應(yīng)氣體控制技術(shù),為介質(zhì)膜的高速高質(zhì)量沉積提供了有力支撐;熱陰極輔助磁控濺射技術(shù)則可顯著提高鍍膜沉積速率。
展望未來(lái),通過(guò)引入弧光放電增強(qiáng)磁控濺射等離子體密度,有望進(jìn)一步克服沉積速率低、金屬離化率低、反應(yīng)沉積工藝難度大等瓶頸,推動(dòng)磁控濺射鍍膜技術(shù)在高新技術(shù)領(lǐng)域發(fā)揮更大作用。
參考文獻(xiàn):
[1]王福貞,武俊偉. 現(xiàn)代離子鍍膜技術(shù) [M]. 北京:機(jī)械工業(yè)出版社,2021.
[2]WANG F Z,WU J W. Modern ion plating technology [M].New York:Elsevier,2022.
[3]王福貞,馬文存. 氣相沉積應(yīng)用技術(shù) [M]. 北京:機(jī)械工業(yè)出版社,2007.
[4]KELLY P J,ARNELL R D. Magnetron sputtering:A review of recent developments and applications[J]. Vacuum, 2000,56(3):159?172.
[5]CHAPMAN B. Glow discharge processes [M]. New York:John Wiley & Sons Inc,1980.
[6]DEPPLA D, MAHIEU S. Reactive sputter deposition [M].Springer-Verlag Berlin Heidelberg,2008.
[7]MATTOX D M. Handbook of physical vapor deposition (PVD)processing [M]. Elsevier Science New York,2010.
[8]FREY H,KHAN H R. Handbook of thin-film technology [M].Springer Science New York,2015.
[9]張以忱. 真空鍍膜技術(shù) [M]. 北京:冶金工業(yè)出版社,2009.
[10]田民波. 薄膜技術(shù)與薄膜材料 [M]. 北京:清華大學(xué)出版社,2011.
[11]WINDOW B,SAVVIDES N. Unbalanced DC magnetrons as sources of high ion fluxes[J]. Journal of Vaccum Science &Technology A,1986,4(3):453?455.
[12]KOMATH M. Studies on the optimization of unbalanced magnetron sputtering cathode[J]. Vacuum,1999,52(3):307?331.
[13]BROWN R,BELLIDO-GONZALEZ V. Comparison of balanced and unbalanced array designs [EB/OL]. [2025-02-25].http//:www.gencoa.com.
[14]TEER D,TEER P. Deposition of material to form a coating:US 2012/0097528 A1 [P]. 2012-04-26.
[15]BAI X Y,TONG Y S,SUN H L. Closed field unbalanced magnetron sputter ion plating technology and its applications in industry[Z]. Teer Company China Agent Company Product Brochure,2024.
[16]MüNZ W D,LEWIS D B,HOVSEPIAN P E,et al. Industrial scale manufactured superlattice hard PVD coatings[J].Surface Engineering,2001,17(1):15?27.
[17]Robertson J. Diamond-like amorphous carbon[J]. Materials Science & Engineering R Reports,2002,37(4/6):129?281.
[18]薛群基,王立平. 類金剛石碳基薄膜材料 [M]. 北京:科學(xué)出版社,2012.
[19]杜軍,何家文. 類石墨碳膜的制備及其與類金剛石碳膜的區(qū)分[J]. 中國(guó)表面工程,2005,18(4):6?8.
[20]付永輝,朱曉東,何家文,等. 非平衡磁控濺射沉積類石墨膜及其摩擦磨損性能研究 [J]. 摩擦學(xué)學(xué)報(bào),2003,23(6):463?467.
[21]王福貞. 一種磁控濺射鍍膜機(jī):201720302687.3[P]. 2017-03-27.
[22]王福貞. 一種磁控濺射鍍膜機(jī):201720302520.7 [P]. 2017-03-27.
[23]達(dá)道安. 真空設(shè)計(jì)手冊(cè) [M]. 第三版. 北京:國(guó)防工業(yè)出版社,2004:851.
[24]王福貞. 一種設(shè)置氣體弧光等離子體清洗源的鍍膜機(jī):20182021443.4 [P]. 2018-02-07.
[25]姜燮昌. 大面積反應(yīng)濺射技術(shù)的最新發(fā)展及應(yīng)用 [J]. 真空,2002,39(3):1?9.
[26]BELLIDO-GONZALEZ V,DANIEL B,COUNSELL J,et. al.Flexible reactive gas sputtering process control[C]//47th Annual Technical Conference Proceedings of the Society of Vacuum Coaters,2004.
[27]BRINDLEY J, BELLIDO-GONZALEZ V, DANIEL B.Vacuum species sensing using remote plasma emission spectroscopy[EB/OL]. [2025-02-25]. http://www.gencoa.com/.
[28]SONG Y Z,SAKURAI T,MARUTA K,et al. Optical and structural properties of dense SiO2 ,Ta2O5 and Nb2O5 thinfilms deposited by indirectly reactive sputtering technique[J]. Vacuum,2000,59(2):755?763.
[29]CHIBA S,MOTOKI A,F(xiàn)UJIKURA K,et al. Metal deposition and oxygen-ion implantation for optical thin films[J].Vacuum,2004,74(3):449?454.
[30]魏榮華. 等離子體增強(qiáng)磁控濺射 Ti-Si-C-N 基納米復(fù)合膜層耐沖蝕性能研究 [J]. 中國(guó)表面工程,2009,22(1):1?10.
[31]李燦民,魏榮華. 等離子體增強(qiáng)磁控濺射沉積(TiAl)納米復(fù)合涂層在鑄鋁模具上的應(yīng)用 [J]. 中國(guó)表面工程,2012,25(2):1?7.
[32]張?chǎng)危鯐悦鳎哝I波. 靶電流密度對(duì)熱絲增強(qiáng)等離子磁控濺射制備 Cr2N 薄膜結(jié)構(gòu)與性能的影響 [J]. 功能材料,2018,49(3):3070?3075.
[33] WEI R H,JAKAB M A,COULTER K,et al. Plasma surface engineering of materials for corrosionc protection[C]//International Conference on Surface Engineering,2018.
[34]桂 剛,田修波,朱宗濤,等. 高功率脈沖磁控濺射電源研制及試驗(yàn)研究 [J]. 真空,2011,48(4):46?50.
[35]WU Z Z,TIAN X B,WANG Z M,et al. Microstructure and mechanical properties of CrN films fabricated by high power pulsed magnetron discharge plasma ion implantation and deposition[J]. Applied Surfice Science, 2011, 258(1):242?246.
[36] 吳忠振,田修波,鞏春志. 基片偏壓模式對(duì)高功率脈沖磁控濺射 CrN 薄膜結(jié)構(gòu)及成分影響的研究 [J]. 稀有材料與工程,2013,42(2):405?409.
[37]吳忠振,田修波,段偉贊,等. 高功率脈沖磁控濺射氬氮比對(duì) ZrN 薄膜結(jié)構(gòu)及性能的影響 [J]. 真空,2011,48(1):13?17.
[38]田修波. 高脈沖磁控濺射的新進(jìn)展與應(yīng)用 [C]//第十六屆全國(guó)薄膜技術(shù)學(xué)術(shù)研討會(huì),北京:中國(guó)真空學(xué)會(huì)薄膜專業(yè)委員會(huì),2023.
(注,原文標(biāo)題:磁控濺射鍍膜技術(shù)新進(jìn)展)
相關(guān)鏈接